Intel晶圓代工於2024年IEEE國際電子元件會議(IEDM)宣布多項突破性進展,其中透過使用新材料減材釕使電晶體容量得以提升25%,並透過先進封裝的異質整合方式使晶片對晶片的吞吐量提高100%,此外為了進一步推動GAA(環繞式閘極)微縮,Intel晶圓代工同步展示矽RibbonFET CMOS及微縮2D FET閘極氧化物模組成果。
Intel晶圓代工希冀藉展示這些技術進一步實現半導體產業於2030年在單晶片容納1兆電晶體的願景。Intel強調半導體需透過新材料提升如PowerVia晶片背部供電解決方案的效益,並緩解互聯密度與持續微縮的壓力,Intel晶圓代工已設立多項途徑解決銅電晶體與未來節點互聯微縮的預期。
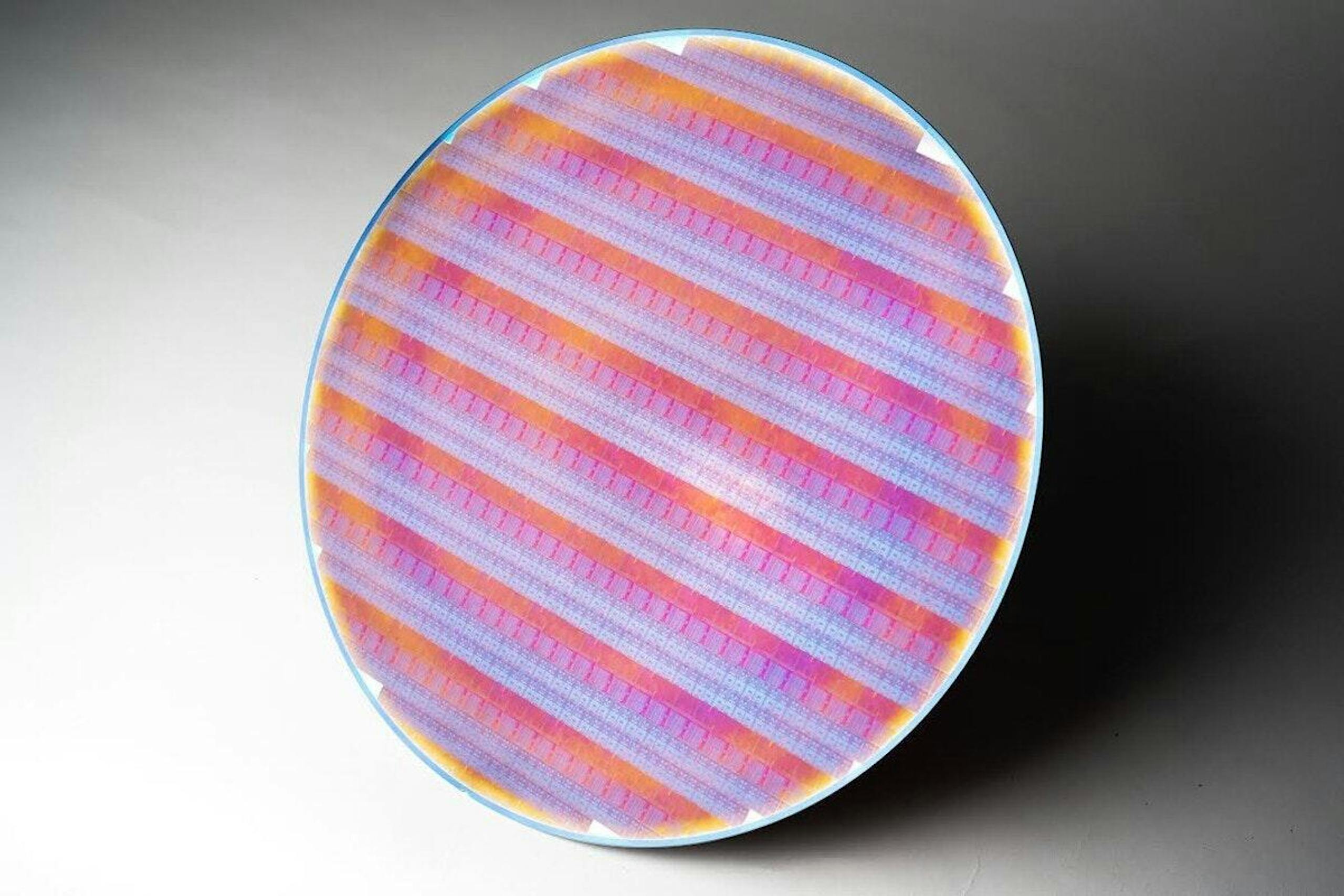
▲Intel希冀透過各項創新材料與技術持續推動摩爾定律
減材釕(Subtractive Ruthenium)
減材釕是Intel於提高晶片內效能與互聯寄予厚望的新材料,是作為取代銅鑲嵌的新一代關鍵替代金屬化材料候選,透過薄膜電阻與氣隙使互聯微縮獲得重大進展;研究團隊在研發測試工具展示兼具實用、具成本效益且適合大量生產的減材釕整合製程,此製程具備氣隙特性,使孔洞周圍不需保留光刻氣隙排除區,也不須選擇性蝕刻自對準孔洞,於間距小於或等於25nm時降低線間電容幅度達25%,Intel已經預計於未來節點導入此項創新材料。
選擇性層遷移(Selective Layer Transfer,SLT)
Intel晶圓代工展示旨在將晶片與晶片吞吐量提升至當前100倍的選擇性層遷移技術,此技術透過異質整合方案使超薄小晶片更具彈性,相對傳統晶片對晶圓鏈合,能使晶粒尺寸更小、深寬比更高,進一步提升更高的功能密度,並對特定小晶片自一個晶圓至另一個晶圓的混合或熔接鏈合提供靈活且具成本效益的解決方案,使AI應用架構的效率與彈性提升。
矽RibbonFET CMOS
Intel晶圓代工為了進一步將RibbonFet(環繞式閘極)矽微縮提升至下一個階段,Intel晶圓代工展示閘極長度為6nm的矽RibbonFET CMOS電晶體,呈現即便在大幅縮減閘極長度與通道厚度仍有領先的短通道效應與效能,將有助使摩爾定律得以持續維持。
用於GAA 2D FET的閘極氧化物
Intel晶圓代工為了加速超越CFET的環繞式閘及創新,展示其GAA 2D NMOS與PMOS電晶體製造成果,將閘極長度縮小至30nm,並聚焦Gox(閘極氧化物)模組開發,呈現業界對於2D過度金屬二硫族化物(TMD)半導體研究,成為矽之後先進電晶體材料的新世代材料候選。
應用於供率供電與射頻的300mm GaN
Intel晶圓代工也持續推進業界首個300mm GaN技術研究,旨在用於功率供電與射頻領域,相較矽,GaN可提供更高效能與承受更高的電壓與溫度,也是業界首款300mm GaN-on-TRSOI基板製造的高效能GaN MOSHEMT(增強型氮化鎵金屬氧化物半導體高電子遷移率電晶體),可實現更低的訊號耗損與更好的訊號線性度,結合背面基板實現先進整合。






















