AMD 在 Ryzen 7000 系列行動平台提供以桌上型平台架構為基礎的 HX 系列,將 PC 級的效能帶到筆電與行動工作站; AMD 在全球指標性遊戲盛事 Chiny Joy 宣布推出 Ryzen 9 7945HX3D ,將 3D V-Cache 技術帶到行動平台,使 AMD 陣營的效能再創新高;同時華碩也將成 Ryzen 9 7945HX3D 首發品牌,預計在 2023 年 8 月 23 日公布 ROG Strix SCAR 17 X3D 。

▲ Ryzen 9 7945HX3D 首發機型華碩 ROG Strix SCAR 17 X3D 將在 8 月底上市
不同於 Intel 透過拉高時脈提高單執行緒效能, AMD 借助更大的快取解決現代遊戲在高幀率描繪時間較短、導致 CPU 與快取傳輸延遲的問題;Ryzen 9 7945HX3D 基於 Ryzen 9 7945HX ,具備 16 核心、 32 執行緒,並可 Boost 達 5.4GHz ,借助 3D V-Cache 技術將快取提高至 144MB ,並擁有 55+W 以上 TDP 設定; AMD 強調為了實現 Ryzen 9 7945HX3D ,採用 AMD 3D 小晶片( 3D Chiplet )技術,透過 TSV 矽穿孔技術,以銅對銅直接連接的方式使 64MB 的 L3 快取與 Zen4 的 CCD 進行 3D 堆疊, Ryzen 9 7945HX3D 也是 AMD 第六款採用 3D V-Cache 技術的處理器。
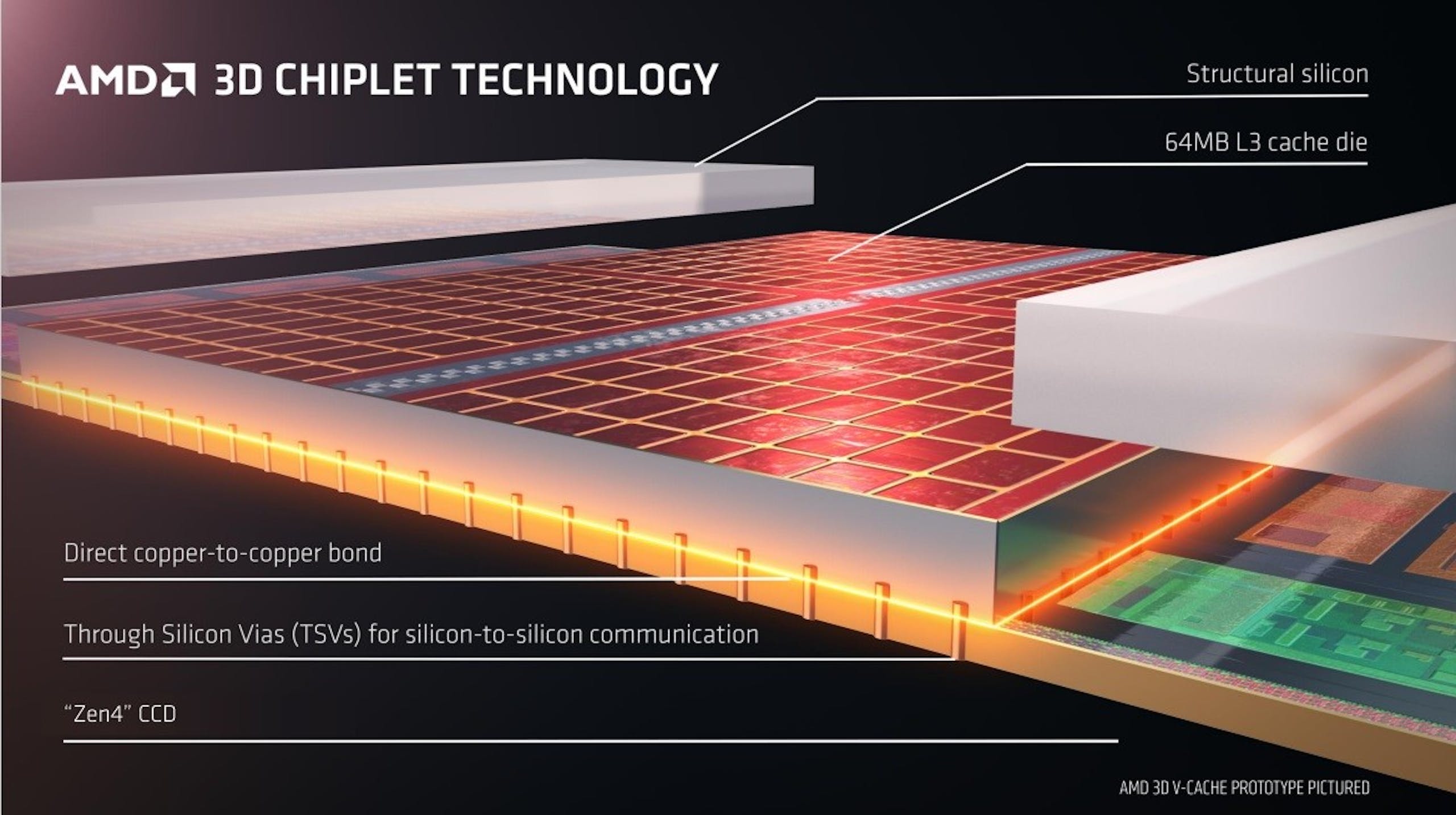
▲ 3D V-Cache 透過 TSVs 矽穿孔與銅對銅做為 3D 小晶片架構的連接方式

▲ 3D V-Cache 採用先進凸點間距穿孔,能有更高的互聯密度與提升傳輸能源效率
AMD 指稱, AMD 的 3D V-Cache 技術使用先進的 Hybrid Bond 3D 技術,僅有 9u 凸點間距,相較使用 2D 封裝的小晶片架構能提升 200 倍的互聯密度,對比使用 50um 凸點間距的 Micrpo Bump 也提高 15 倍互連密度與提高 3 倍的傳輸能源效率。

▲在搭配 RTX 4090 的筆電系統下以 FullHD 的古墓奇兵:暗影測試,在設為 40W TDP 的與 70W TDP 與沒有 3D V-Cache 版本比較都有提升

▲多了 3D V-Cache 遊戲效能平均提升 15%
不同於 Intel 藉由提高 Boost 時脈提高效能, AMD 則是利用 3D V-Cache 倍增 L3 快取容量,根據 AMD 提供的效能對比,相對沒有 3D V-Cache 的 Ryzen 9 7945HX , Ryzen 9 7945HX3D 的遊戲效能平均提升 15% ,也使得 Ryzen 9 7945HX3D 成為 AMD 新一代的行動處理器王者;此外大容量快取也為在電力資源受限的情況帶來顯著的效能提升,對照 Ryzen 9 7945HX 相同 TDP 設定,Ryzen 9 7945HX3D 於 70W TDP 提升 11% 效能,但縮限於 40W 下則高出 23% 效能。






















